Electrical SPM Method
導電性原子間力顕微鏡法(C‑AFM)
Conductive Atomic Force Microscopy(C‑AFM)
形状観測から 2 次元電流マップ、局所 I–V 特性評価まで。一本の導電性プローブが定義する、ナノスケール電気特性解析手法です。
Measurement Principle
導電性プローブで形状と局所電流を同時取得する C‑AFM 測定
C‑AFM は、導電性材料でコーティングされた AFM 探針を「ナノ電極」として用い、試料表面を走査しながら形状(Topography)と局所的な電流分布(Current Map)を同時に取得する手法です。
試料に一定のバイアス電圧を印加し、探針と試料間に流れる電流を計測します。ナノメートルオーダーの極微細な接触点におけるオームの法則(I = V / R)に基づき、場所ごとの抵抗の差異を電流の濃淡として可視化することで、絶縁膜の劣化や意図しないリーク経路をダイレクトに捉えることが可能です。
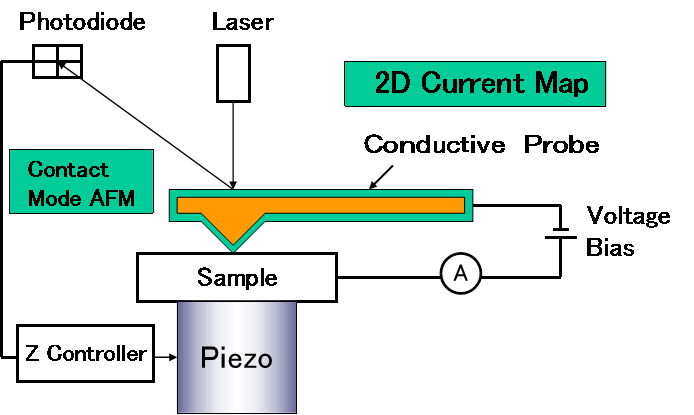
Features
C‑AFM によるナノスケール電気特性評価の特徴
形状と電流分布の相関解析
最大の特徴は、物理的な形状像と電流マッピング像を同一視野で取得できる点にあります。これにより、構造的な欠陥や微細なデバイス構造が、実際の電気伝導やリーク特性にどう影響しているかをナノスケールで直接相関させることが可能です。
ポイント計測(局所 I–V 特性評価)
画像化(イメージング)に加え、C‑AFM の極めて重要な機能が、イメージングで特定した箇所や注目点に停止して行う局所ナノプロービングによる I–V 特性計測です。特定ドメインや欠陥部の伝導メカニズムを、局所的に切り出して評価できます。
物理量の定量化
局所 I–V 特性から、ショットキー障壁、トンネル電流、絶縁膜の信頼性・耐圧特性などを定量的に評価します。C‑AFM によるナノスケール電流マップと組み合わせることで、従来のマクロ電気評価では見えない空間的不均一性を明らかにします。
Metrix C‑AFM Strengths
高抵抗絶縁膜から2D材料までをカバーする C‑AFM 解析
高抵抗のゲート絶縁膜から極めて低抵抗の 2D グラフェンシートまで、幅広い抵抗範囲の薄膜材料における電流マッピングおよびナノプロービング計測が特徴です。
高感度かつ非破壊的計測によるゲート絶縁膜信頼性評価
フェムトアンペア(fA)オーダーの微小電流を検出可能な高感度 C‑AFM により、ゲート絶縁膜への電気的負荷を抑えつつ、本来の故障メカニズムを維持したままリーク経路や劣化箇所を観察します。ゲート絶縁膜信頼性フィジビリティ検証に活用できます。
次世代ナノ材料:グラフェン・導電性高分子の局所導電性解析
グラフェンなどの 2 次元材料や導電性高分子に対し、局所導電性のばらつきやドメイン構造を C‑AFM で可視化します。キャリア輸送経路や界面の不均一性を明らかにし、デバイス設計・材料設計へのフィードバックに貢献します。
ワイドバンドギャップパワーデバイス材料(SiC / GaN)
転位やパイプ欠陥に起因する局所的な耐圧不良箇所を、電流マップとして直接同定します。SiC / GaN デバイスのリーク起点やフィールド集中領域を特定し、プロセス改善や設計見直しにつなげます。
先端抵抗変化メモリ(ReRAM)
抵抗変化層内のフィラメント形成・消失を C‑AFM による電流マップと局所 I–V 測定で追跡し、動作フィジビリティ検証やスイッチングメカニズムの理解に貢献します。